物質表面・界面の深さ方向の構造の決定
| 測定対象 : | 塗料塗布材、薄膜、フィルム |
|---|---|
| 測定試料例 : | 情報・通信、化学、エネルギー、医療・生体、繊維・素材、機械、鉄鋼・金属、建設、食品(詳細はこちら) |
概要
SUIRENは、平滑な物質界面で反射した中性子を計測することで、物質表面付近の1 nmから数μm程度までの深さ方向の構造や表面に成膜した薄膜・多層膜の層構造を非破壊で解析する装置です。表面構造を知ることは、フィルムやコーティング材の透過特性、撥水性、腐食反応、機能性材料表面の反応性、吸着、生体膜の機能のメカニズムを理解することに繋がるため、様々な場面でその重要性が高まっています。中性子の特長である同位体識別能や磁気モーメントの観測能を生かすことで、軽元素だけで構成される高分子や界面活性剤等のソフトマター、磁性薄膜中の磁気界面などの研究も進められています。本装置は、測定面を垂直に立てる形で試料を設置するため、試料形態としては、固体試料またはセルに入れた状態の固液界面試料が対象となります。中性子反射率の角度依存性を解析することによって、各層での密度、組成、層厚、層間の界面粗さの情報などが得られます。また、偏極中性子が利用できますので、磁性膜を含む多層磁気構造を解析し、磁化の深さ方向分布を同定することができます。
装置詳細
| 形式 | 試料垂直配置型 |
|---|---|
| 中性子源 | 冷中性子源 (液体水素モデレーター20 K) |
| 中性子波長 | λ = 0.393 nm PG (002) (Δλ/λ = 2.6%) |
| 最大ビームサイズ | H 80 mm × W 10 mm2 |
| 強度(Δθ = 0.08 deg) | 1.8 × 104n/cm2/s |
| バックグラウンド | 4.5 × 10-3n/s |
| 検出器 | 0次元検出 |
| 到達可能反射率 | 10-6以下 |
| 偏極率 | 0.96以上 |
測定試料例
| 情報・通信 | フォトレジスト、Low-k、High-k材料、HDD、量子ドットレーザー、フォトニック結晶 |
|---|---|
| 化学 | 触媒、腐食、界面活性、接着、粘性、濡れ |
| エネルギー | 燃料電池、太陽電池、超電導材料、水素吸蔵材料 |
| 医療・生体 | 生体膜、バイオセンサー |
| 繊維・素材 | 撥水・親水処理 |
| 機械 | 摺動、潤滑、接合、センサー |
| 鉄鋼・金属 | 熱処理、塗装、めっき、酸化膜 |
| 建設 | 軽量構造材料、耐候性材料、遮光ガラス |
| 食品 | 包装フィルム、濾過、分離・精製、生分解性プラスチック |
これまでSUIRENで行われた研究対象の例
-
中性子反射率による単分子層修飾金電極の構造解析
-
Bi系高密度光記録材料薄膜の深さ方向の組成分布解析
-
NdFeBの表面磁気構造評価
-
コンデンサ界面の解析
-
Fe/炭化物スパッタ多層膜の中性子反射率測定による水素トラップ状態の検討
-
中性子反射率によるバイオ燃料電池電極界面の構造解析
-
磁気ヘッド膜の反強磁性/強磁性界面 における磁気構造の評価
-
中性子反射率法によるシロキサン樹脂膜の評価
-
TiO2薄膜の5nm不完全極薄膜の薄膜密度の測定技術の調査
-
多層膜中の酸化物膜に挟まれる10nm金属膜の正確な膜厚と密度の測定技術
-
合わせガラスにおける中間膜/ガラス界面の評価
-
銅エポキシ樹脂接合界面の中性子反射率測定による研究
-
垂直磁気記録多層薄膜界面磁気構造の解析
-
シリコンを添加したダイヤモンドライクカーボン(DLC-Si)薄膜の表面構造解析
-
鉄鋼材料の表層酸化物の組成および構造解析
-
磁気デバイス用反強磁性/強磁性交換結合膜における界面磁気構造の解明
-
水素フリーDLC膜の膜密度評価
-
「中性子利用技術移転推進プログラム」業務実施結果報告書(文部科学省)http://www.mext.go.jp/a_menu/shinkou/ryoushi/detail/1323226.htm
測定例
Fig.1にSUIRENで得られた標準試料の反射率曲線を示します。 Fig.1(a)に示すはシリコン基板、次の例Fig.1(b)はSi基板上のNi単層膜の実測データとfitting曲線です。Si基版からの反射率はどこまで小さな反射率の値にまで到達できるかの指標として良く使われます。 基板の厚さが0.5 mmであるため、実質的に基板の厚さを無限大と見なして良く、実際に低いq領域で全反射した後、qが大きくなるにつれて単調に減衰する、表面反射のみの反射率曲線が得られています。 この例から10-6領域までの反射率測定が可能な事がわかります。Si基板の上に50 nmのNiを積層すると、表面で反射した中性子と表面を透過しNiとSiの基板界面で反射して戻ってきた位相の異なる中性子が干渉します。 その干渉によって生じる干渉縞がFig. 1(b) にきれいに観測されています。また、干渉縞の間隔から膜厚(この場合には50nm)や反射率曲線の減衰の度合いから表面や界面の構造の乱れ(ラフネス)を知ることが可能です。
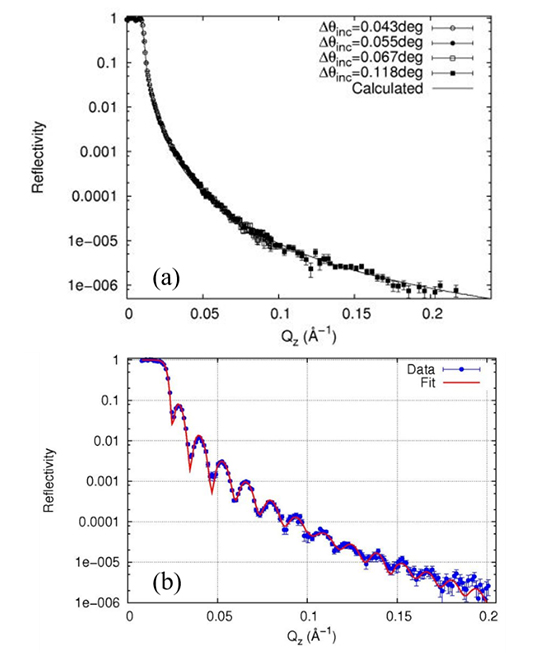
関連資料
SUIRENの紹介
-
「JRR-3における中性⼦反射率計の開発」山﨑 ⼤らJAEA-Technology 2007-030 (2007).
https://doi.org/10.11484/jaea-technology-2007-030 -
「SUIREN(偏極中性⼦反射率計)」武⽥ 全康 波紋 2021年 31巻 1号 p.18-19
https://doi.org/10.5611/hamon.31.1_18
⼊⾨講座「中性⼦反射率測定」
-
「中性子反射率測定入⾨講座の企画に当たって」高原 淳 波紋 2008年 18巻 4号 p.220
https://doi.org/10.5611/hamon.18.220 -
「中性⼦反射率法の原理」⿃飼 直也、武⽥ 全康 波紋 2008年 18巻 4号 p.221-227
https://doi.org/10.5611/hamon.18.221 -
「中性⼦反射率測定」⼭﨑 ⼤、⽇野 正裕 波紋 2009年 19巻 1号 p.34-40
https://doi.org/10.5611/hamon.19.1_34 -
「⾼分⼦/⾼分⼦界⾯における分⼦鎖の拡散」川⼝ ⼤輔、松下 裕秀 波紋 2009年 19巻 2号
https://doi.org/10.5611/hamon.19.2_101 -
「⾼分⼦/液体界⾯」新 史紀、藤井 義久、⽥中 敬⼆ 波紋 2009年 19巻 2号 p.105-108
https://doi.org/10.5611/hamon.19.2_105 -
「⾼分⼦薄膜の熱物性と安定性」⾦⾕ 利治、川島 和⼦、井上 倫太郎、宮崎 司 波紋 2009年 19巻 3号 p.161-164
https://doi.org/10.5611/hamon.19.3_161
装置利用や課題申請について
詳細はこちら(https://jrr3uo.jaea.go.jp/information/information_04.htm)